 2022-05-30
2022-05-30
芯片制造
芯片制造是将芯片从图纸变成实物的关键一步,但在芯片量产之前还有个重要步骤就是流片,也就是人们常说的试生产。
流片之于芯片开发者,相当于考试之于学生,学生“闻考变色”,芯片开发者“闻流片变色”,究其原因在于,流片失败的代价太过严重,一次流片失败往往意味着几百万甚至上千万的损失以及至少半年市场机遇的错失。不少初创型芯片企业就因流片失败而消失在茫茫芯片产业长河里,言归正传,那芯片制造到底又有多少步骤,为啥能让企业“闻流片变色”?据了解,一条芯片生产线大约涉及2000-5000道工序,笔者可能无法面面俱到得全部介绍,因此只能介绍一些关键步骤。
从大方面来讲,晶圆生产包括晶棒制造和晶片制造两大步骤,再加上晶圆针测工序,统称为晶圆制造前道工艺,而下文中即将介绍的封装和测试则称为晶圆制造后道工艺。
1.提纯:沙子/石英经过脱氧提纯以后的得到含硅量25%的二氧化硅,再经由电弧炉提炼,盐酸氯化,并蒸馏后,得到纯度高达99%以上的晶体硅。
2.晶棒制造:晶体硅经过高温熔化,采用旋转拉伸的方法,经过颈部成长、晶冠成长、晶体成长、尾部成长,得到一根完整的晶棒。
3.切片:将晶棒横向,采用环状、其内径边缘镶嵌有钻石颗粒的薄片锯片切成厚度基本一致的晶圆片。
4.打磨抛光:对晶圆外观进行打磨抛光,去掉切割时在晶圆表面产生的锯痕和破损,使晶片表面达到所要求的光洁度。
5.氧化:其表面进行氧化及化学气相沉积,一是可做后期工艺的辅助层,二是协助隔离电学器件,防止短路。
6.光刻和刻蚀:在氧化后的晶圆表面旋涂一层光刻胶,随后对其进行曝光,再通过显影把电路图显现出来。再用化学反应或用等离子体轰击晶圆表面,实现电路图形的转移。
7.离子注入、退火:把杂质离子轰入半导体晶格,再将离子注入后的半导体放在一定温度下加热,从而激活半导体材料的不同电学性能。
8.气相沉积、电镀:气相沉积用于形成各种金属层以及绝缘层,电镀专用于生长铜连线金属层。
9.化学机械研磨:用化学腐蚀和机械研磨相结合的方式进行磨抛。
10.最终在晶圆上完成数层电路及元件加工与制作。
11.晶圆针测工序:用针测仪对每个晶粒检测其电气特性,舍弃不合格晶粒。
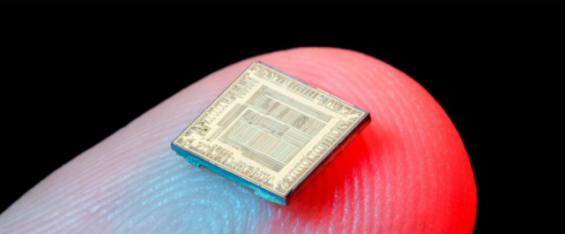
芯片封测
封测就是上述提到的晶圆制造后道工艺中的封装和测试,其中封装是指将通过测试的晶圆加工得到芯片的过程,测试是检测不良芯片,包括封装前的晶圆测试和成品测试。
作为芯片生产前的最后一公里,封测对于芯片成品来说也是至关重要的一步,封装可以对芯片起到保护、支撑、连接、散热、可靠性等作用,而测试可以保证芯片质量,甚至提升出货质量,避免瑕疵芯片的流出。具体来看封测步骤主要分为:
1.背面减薄:对晶圆进行背面减薄,达到封装需要的厚度。
2.晶圆切割:将晶圆切割成一个个独立的Dice,再对Dice进行清洗。
3.光检查:检查是否出现废品。
4.芯片粘接:芯片粘接,银浆固化(防止氧化),引线焊接。
5.注塑:防止外部冲击,用EMC(塑封料)把产品封装起来,同时加热硬化。
6.激光打字:在产品上刻上生产日期、批次等内容。
7.高温固化:保护IC内部结构,消除内部应力。
8.去溢料:修剪边角。
9.电镀:提高导电性能,增强可焊接性。
10.切片成型检查废品。
11.芯片测试:分为一般测试和特殊测试,一般测试是测试芯片的电气特性,依其电气特性划分为不同等级。而特殊测试则是有针对性的专门测试,看是否能满足客户的特殊需求。
12.测试合格的产品贴上规格、型号及出厂日期等标识的标签并加以包装后即可出厂。



