 2022-01-11
2022-01-11
正装芯片通常是用来进行传统的小功率φ3~φ10的封装,倒装芯片通常是功率芯片,主要用来封装大功率LED(>1W),。因此,功率不同导致二者在封装及应用的方式均有较大的差别,主要区别有如下几点:
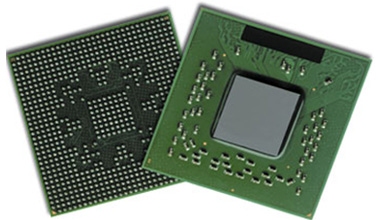
一、 正装芯片与倒装芯片的区别:
金线支架荧光粉胶水散热设计正装小芯片φ0.8~φ0.9mil直插式YAG环氧树脂无倒装芯片φ1.0~φ1.25milDome PowerYAG或硅酸盐荧光粉硅胶散热基板
二、正装芯片与倒装芯片的结构
正装芯片结构
正装芯片是最早出现的芯片结构,该结构中从上至下依次为:电极,P型半导体层,发光层,N型半导体层和衬底,该结构中PN结处产生的热量需要经过蓝宝石衬底才能传导到热沉,蓝宝石衬底较差的导热性能导致该结构导热性能较差,从而降低了芯片的发光效率和可靠性。
倒装芯片结构:
倒装芯片结构从上至下依次为蓝宝石衬底、N型半导体层,发光层,P型半导体层和电极,与正装结构相比,该结构中PN结处产生的热量不经过衬底即可直接传导到热沉,因而散热性能良好,芯片发光效率和可靠性较高;倒装结构中,p电极和n电极均处于底面,避免了对出射光的遮挡,芯片出光效率较高;此外,倒装芯片电极之间距离较远,可减小电极金属迁移导致的短路风险。
三、正装芯片与倒装芯片封装制程区别:
(1).固晶:正装小芯片采取在直插式支架反射杯内点上绝缘导热胶来固定芯片,而倒装芯片多采用导热系数更高的银胶或共晶的工艺与支架基座相连,且本身支架基座通常为导热系数较高的铜材;
(2).焊线:正装小芯片通常封装后驱动电流较小且发热量也相对较小,因此采用正负电极各自焊接一根φ0.8~φ0.9mil金线与支架正负极相连即可;而倒装功率芯片驱动电流一般在350mA以上,芯片尺寸较大,因此为了保证电流注入芯片过程中的均匀性及稳定性,通常在芯片正负级与支架正负极间各自焊接两根φ1.0~φ1.25mil的金线;
(3).荧光粉选择:正装小芯片一般驱动电流在20mA左右,而倒装功率芯片一般在350mA左右,因此二者在使用过程中各自的发热量相差甚大,;
(4).胶体的选择:正装小芯片发热量较小,因此传统的环氧树脂就可以满足封装的需要;而倒装功率芯片发热量较大,需要采用硅胶来进行封装;
(5).点胶:正装小芯片的封装通常采用传统的点满整个反射杯覆盖芯片的方式来封装,而倒装功率芯片封装过程中,由于多采用平头支架,因此为了保证整个荧光粉涂敷的均匀性提高出光率而建议采用保型封装(Conformal-Coating)的工艺;示意图如下:
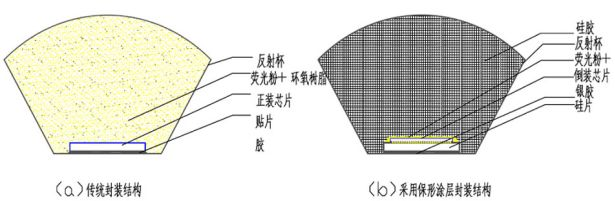
(6).灌胶成型:正装芯片通常采用在模粒中先灌满环氧树脂然后将支架插入高温固化的方式;而倒装功率芯片则需要采用从透镜其中一个进气孔中慢慢灌入硅胶的方式来填充,填充的过程中应提高操作避免烘烤后出现气泡和裂纹、分层等现象影响成品率;
(7).散热设计:正装小芯片通常无额外的散热设计;而倒装功率芯片通常需要在支架下加散热基板,特殊情况下在散热基板后添加风扇等方式来散热;在焊接支架到铝基板的过程中 建议使用功率<30W的恒温电烙铁温度低于230℃,停留时间<3S来焊接;
(8).封装后成品示意图:

LED芯片封装技术已经形成几个流派,不同的技术对应不同的应用,都有其独特之处。可以发现,倒装芯片发光效率高、散热性好、可靠性高、量产能力强,更适用于小间距和微间距显示产品。



