 2022-05-10
2022-05-10
芯片封装即安装半导体集成电路芯片用的外壳,具有安放、固定、密封、保护芯片和增强电热性能的作用。芯片封装是沟通芯片内部世界与外部电路的桥梁,芯片的接点用导线连接到封装外壳的引脚上,引脚又通过印制板上的导线与其他器件建立连接;封装对CPU和其他LSI集成电路都起着重要的作用,引脚数增多,引脚间距减小、重量减小、可靠性提高,使用更加方便。
ICPackage(IC包装形式)指芯片(Die)和不同类型的框架(L/F)和塑料密封(EMC)形成的不同形状的密封。
IC种类繁多,可按以下标准分类:
按包装材料分为:
金属包装、陶瓷包装、塑料包装。
金属包装主要用于军工或航天技术,无商业产品;
陶瓷包装优于金属包装,也用于军事产品,占据少量商业市场;
由于成本低、工艺简单、可靠性高,塑料包装用于消费电子;
按与PCB板的连接方式分为:
PTH包装和SMT包装。
PTH-Pinthroughole,通孔式;
SMT-SurfaceMountechnology,表面贴装式。
目前市场上大部分IC都是SMT式的。
按包装外观可分为:
SOT、SOIC、TSSOP、QFN、QFP、BGA、CSP等。
决定封装形式的两个关键因素:
密封效率。芯片面积/密封面积尽可能接近1:1;
引脚数。引脚越多,越先进,但工艺难度也相应增加;
其中,CSP是目前更先进的技术,采用FlipChip技术和裸片包装,达到芯片面积/包装面积=1:1;
QFN-QuadFlatNo-leadPackage四方无引脚扁平封装。
SOIC-SmaloutlineIC小外观IC封装。
TSSSOP-ThinSmalShrinkoutlinePackage薄外观封装。
QFP-QuadFlatPackage四方引脚扁平封装。
BGA-BalgridArayPackage球栅阵列封装。
CSP-ChipScalePackage芯片尺寸级封装。
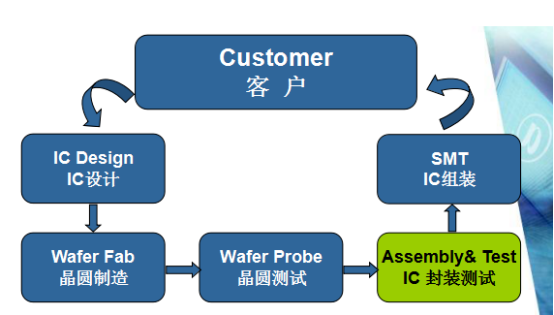
引线框架。
提供电路连接和Die固定功能;
主要材料为铜、镀银、NiPdau等材料;
L/F有Etch和Stamp两种工艺;
易氧化,储存在氮气柜中,湿度小于40%RH;
除BGA和CSP外,其他Package都采用LeadFrame,BGA采用Substrate;
焊接金线。
实现芯片与外部引线框架之间的电物理连接;
金线采用99.99%的高纯度金;
同时,出于成本考虑,目前采用铜线和铝线技术。优点是降低成本,增加工艺难度,降低产量;
线径决定可传导电流;0.8mil、1.0mil、1.3mils、1.5mils和2.0mils;
MoldCompound塑料密封/环氧树脂。
主要成分为:环氧树脂及各种添加剂(固化剂、改性剂、脱模剂、染色剂、阻燃剂等);
主要功能是:在熔融状态下包裹Die和LeadFrame,提供物理和电气保护,防止外界干扰;
储存条件:零下5°保存,常温下需要回温24小时。



